我們知道,在半導(dǎo)體生產(chǎn)過程中,晶圓加工工藝過程復(fù)雜,為保證質(zhì)量,幾乎加工過程中的每一步工序質(zhì)量都需要進(jìn)行檢測(cè),否則缺陷產(chǎn)品流入下一道工序,不僅對(duì)產(chǎn)品的整體質(zhì)量有很大影響,而且會(huì)造成生產(chǎn)成本的巨大浪費(fèi)。晶圓鍵合檢測(cè)設(shè)備就成為其中一道重要環(huán)節(jié)設(shè)備。
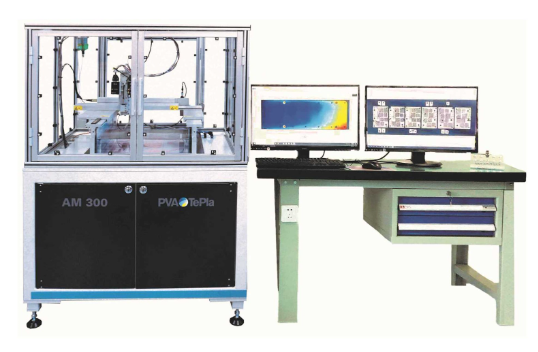
晶圓加工時(shí),很多缺陷會(huì)呈現(xiàn)在晶圓表面,針對(duì)這些表面缺陷,國(guó)內(nèi)半導(dǎo)體企業(yè)則仍有很多依然在使用效率低下的人工檢測(cè)手段,今年,華中科技大學(xué)教授劉世元團(tuán)隊(duì)在《極端制造》發(fā)表綜述文章,對(duì)過去10年中與光學(xué)晶圓缺陷檢測(cè)技術(shù)有關(guān)的新興研究?jī)?nèi)容進(jìn)行了全面回顧。傳統(tǒng)明場(chǎng)檢測(cè)方法是當(dāng)前晶圓缺陷檢測(cè)的主流技術(shù),但受制于光學(xué)成像分辨率極限和弱散射信號(hào)捕獲能力極限而變得難以為繼,因此亟須探索具有更高成像分辨率和更強(qiáng)缺陷散射信號(hào)捕獲性能的缺陷檢測(cè)新方法。
該綜述研究總結(jié)了代表性晶圓缺陷檢測(cè)新方法,新進(jìn)展包含缺陷可檢測(cè)性評(píng)估、光學(xué)缺陷檢測(cè)方法、后處理算法等3個(gè)方面。但對(duì)不是研究這一塊領(lǐng)域的企業(yè)來說,晶圓鍵合檢測(cè)技術(shù)還有什么方法或者設(shè)備可以檢測(cè)出缺陷晶圓呢?
科視達(dá)持續(xù)不斷發(fā)展的超聲波掃描顯微鏡技術(shù),為廣大需求者提供了創(chuàng)新的超聲掃描分析解決方案,使得超聲波賽秒顯微鏡被更為廣泛地應(yīng)用于材料科學(xué),半導(dǎo)體行業(yè),生物學(xué),太陽(yáng)能以及晶圓鍵合缺陷檢測(cè)等領(lǐng)域,給傳統(tǒng)的精細(xì)結(jié)構(gòu)觀察帶來了全新的方法。
在檢測(cè)時(shí),晶圓被固定不動(dòng)在真空泵吸附力的卡盤上,并與如同細(xì)如毛發(fā)薄的探頭針電測(cè)器指向,與去同時(shí)探頭針與芯片的每一個(gè)電焊焊接墊相觸碰,電測(cè)器在電源的驅(qū)動(dòng)器下檢測(cè)電源電路并紀(jì)錄下結(jié)果,檢測(cè)的總數(shù)、順序和種類由電子計(jì)算機(jī)系統(tǒng)控制,測(cè)試機(jī)是自動(dòng)化技術(shù)的,因此在探頭針電測(cè)器與開始的一片晶圓對(duì)準(zhǔn)后(人力指向或應(yīng)用全自動(dòng)視覺識(shí)別系統(tǒng))的檢測(cè)工作中不必操作工的輔助。
晶圓檢測(cè)是主要的芯片產(chǎn)品合格率統(tǒng)計(jì)分析方法之一,伴隨著芯片的總面積擴(kuò)大和相對(duì)密度提升促使晶圓檢測(cè)的花費(fèi)越來越大,這樣一來,芯片必須更長(zhǎng)的檢測(cè)時(shí)間及其更為高精密繁雜的電源、機(jī)械設(shè)備和計(jì)算機(jī)系統(tǒng)來實(shí)行檢測(cè)工作中和監(jiān)管檢測(cè)結(jié)果,科視達(dá)超聲波顯微鏡就成為了晶圓鍵合檢測(cè)的好伙伴。如果你也有相關(guān)需求,歡迎前來咨詢!